
|
●平10年異議第70036号
長期間要望されかつ不実施であった課題/2次的考察/進歩性
| [事件の概要] |
| ①甲は「半導体結晶膜の成長方法」の発明について特許出願を行い、特許を取得しました。 ②特許権の設定登録時に特許出願の願書に添付された特許請求の範囲に記載された発明は次の通りです。 (イ)加熱された基板の表面に半導体結晶膜を成長させる方法において、 (ロ)基板の表面に平行ないし傾斜する方向には反応ガスを供給し、 (ハ)基板の表面に対して実質的に垂直な方向には、反応ガスを含まない不活性ガスの押圧ガスを供給し、 (ニ)不活性ガスである押圧ガスが、基板の表面に平行ないし傾斜する方向に供給される反応ガスを基板表面に吹き付ける方向に方向を変更させて、半導体結晶膜を成長させることを特徴とする半導体結晶膜の成長方法。 本件発明 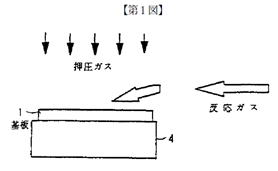 引用例1 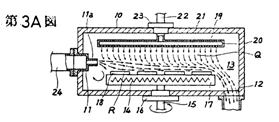 ③特許権設定時の特許出願の願書に添付された明細書(特許明細書)によれば、本件発明の目的は、「基板表面に大面積の半導体結晶膜を高い歩留で成長できる半導体結晶膜の成長方法を提供する」ことです。 ④上記特許明細書には本件発明の効果に関して次のように記載されています。 (イ)「基板と平行な方向と垂直な両方向に反応ガスを供給する従来の半導体結晶膜の成長方法は、供給された反応ガスが、高温に加熱された基板による激しい熱対流のために拡散してしまう。このため、理想的な状態で反応して半導体結晶膜として成長できない。したがって、この方法で、たとえば、好ましい結晶状態に成長させるのが難しいとされる窒化物半導体を成長させると、窒素空孔が多くなり、結晶欠陥の多い半導体結晶膜となる。」 (ロ)「これに対して、本発明の実施例1の方法で成長された窒化物半導体は、キャリア濃度が1×1018/cm3、ホール移動度が250cm2/V・secと、従来の方法とは比較にならない極めて優れた結晶性を示した。本発明の成長方法が、このように、優れた結晶性の半導体結晶膜を成長できるのは、反応ガスを基板と平行に供給し、反応ガスを含まない不活性ガスである押圧ガスを、基板に垂直に供給するからである。この状態で基板に供給される反応ガスは、高温加熱の基板表面にできる激しい熱対流に起因する弊害を押圧ガスによって解消し、さらに、基板上で分解されて優れた結晶性の半導体結晶膜として成長される。」 (ハ)「さらに、この発明の半導体結晶膜の成長方法で、サファイヤ基板の表面に半導体結晶膜を成長させると、外径が2インチφのサファイア基板を使用して、その全体にGaNを成長できる。これに対して、従来の方法は、2インチφのサファイヤ基板を使用するにもかかわらず、表面に成長させた半導体結晶膜の有効面積は僅かに10mmφ以下にしかならない。」 ⑤この特許に対して異議申立が行われ、甲は、発明の名称を「窒素化合物半導体結晶膜の成長方法」と訂正するとともに、特許請求の範囲を次のように訂正しました。 (イ)加熱された基板の表面に窒素化合物半導体結晶膜をMOCVD法でもって常温で成長させる方法において、 (ロ)基板の表面に平行ないし傾斜する方向には、窒素化合物半導体の原料となる反応ガスを供給し、 (ハ)基板の表面に対して実質的に垂直な方向には、反応ガスを含まない不活性ガスの押圧ガスを供給し、 (ニ)不活性ガスである押圧ガスが、基板の表面に平行ないし傾斜する方向に供給される、窒素化合物半導体の原料となる反応ガスを基板表面に吹き付ける方向に方向を変更させて、半導体結晶膜を成長させることを特徴とする窒素化合物半導体結晶膜の成長方法。 ⑥異議申立理由は、引用例1及び引用例2から本件発明を容易に発明できるから、進歩性を欠いているということです。 ⑦引用例1には、発明の構成について次の記載があります。 「(1)密閉槽内に配設された基板の表面にほぼ平行に第1のガス流をシート状に導入し、かつ前記基板の表面に対向するように第2のガスを導入して、前記基板の表面の近傍に第1のガス流の層流状態を保持するようにしたことを特徴とするCVD装置のガスフロー方法。…(4)前記第1のガス流は反応性ガスから成る…CVD装置のガスフロー方法。(5)前記第2のガス流は不活性ガスから成る…CVD装置のガスフロー方法。」  ⑧引用例1には、その作用効果について次の記載があります。 (イ)「第1のガス流を基板付近全域に於いて制御性の良い層流状態に保つことができる。すなわち第2のガス流は基板近傍で第1のガス流の舞い上がり力学的に抑え込むと共に第1のガス流の成分の乱流拡散を防止する。」 (ロ)「本ガスフロー方法で…タングステン・シリサイド膜の成長を実施した」 (ニ)「以上の実施例では、いわゆる熱CVDによる薄膜形成が説明されたが、プラズマCVDや光CVDなどにも…適用可能である。また以上の実施例では真空槽内での処理が説明されたが、真空を必要としない常圧でも基板への表面可能が可能なCVD装置にも本発明は適用可能である。」 ⑨さらに引用例2には、次の記載があります。 (イ)「金属元素を含んだ反応性を有するガスと金属元素を含んでいない反応性を有するガスとを減圧下の反応槽内の基板の表面にほぼ平行にシート状の流れで導入し、かつ前記基板の表面に対向するように不活性ガスのガス流又は不活性ガスを主体とするガス流を導入しながら、前記基板に加熱ランプの光を照射し、前記基板の表面に前記金属元素を含んだ薄膜を形成することを特徴とするCVD法。」 (ロ)「上記実施例では、金属元素を含んだ半王政を有するガスにWF6を用いているが、これに限定されず、金属元素を含んだ反応性を有するガスはいかなるものであってもよく、例えば、MoF6…等の金属ハロゲン化物のいずれか1つ又はそれら2つ以上の組み合わせであってもよい。」 |
| [審判部の判断] |
| 審判官の合議体は、次の理由で本件発明の進歩性を認め、異議理由を否定しました。 (イ)引用例1及び2には、「窒素化合物半導体の原料となる反応ガスを供給」すること、及び、「MOCVD法でもって常温で成長させる」ことが開示されていない。 (ロ)これらの構成により、結晶性の良い状態で成長させるのが極めて難しいとされる窒素化合物等の半導体結晶膜を、優れた結晶状態に成長できる、という効果を生じる。 |
| [コメント] |
| ①或る課題の実現が長年に亘って市場において要望されていながら、その課題を実現する発明が実施されなかったという事実は、進歩性の判断において大いに評価されます。青色発光ダイオードの実用化はまさにそれにあたります。仮に引用例1~2に開示されていた2方向からガスを吹き付ける方法を利用して、青色発光ダイオードを実現することが容易であるなら、他の誰が既にそれを試みている筈であるという推測が働くからです。 ②なお、発明の創作困難性の態様の一つとして、実現するために非常に多くの試行を繰り返さなければならない、という場合がありますが、本件発明の場合には、これに該当すると考えられます。多くの試行を要する場合であっても、“有限かつ公知の選択肢”の中で試行を行えばよいことが予め判っているときには、進歩性が否定される傾向があります。しかしながら、本件の発明の場合には、例えば反応ガスと押圧ガスとを使って青色発光ダイオードができるという手掛かりが全くない状態から本件発明の構成に辿り着いたのですから、“有限かつ公知の選択肢”の中での試行という条件には当てはまりません。 |
| [特記事項] |
| 戻る |
今岡憲特許事務所 : 〒164-0003 東京都中野区東中野3-1-4 タカトウビル 2F
TEL:03-3369-0190 FAX:03-3369-0191

営業時間:平日9:00~17:20
今岡憲特許事務所TOPページ | はじめに | 特許について | 判例紹介 | 事務所概要 | 減免制度 | リンク | 無料相談
Copyright (c) 2014 今岡特許事務所 All Rights Reserved.

